01
背景介绍
超宽禁带半导体氧化镓(Ga2O3)材料,具备高达4.8-4.9 eV的超宽禁带宽度、极高的临界击穿电场强度(约8 MV/cm)以及可通过熔体法生长大尺寸低成本单晶衬底的潜力,是制备超高压、低损耗、高性价比的下一代功率半导体器件极具前途的候选者,如图1所示β-Ga2O3与主流半导体的基本物理性质。目前Ga2O3功率器件已在实验室阶段展示出了卓越的性能指标,未来将有望在万伏级电力变换与传输、轨道交通牵引、极端环境能源系统等关键领域实现革命性应用。
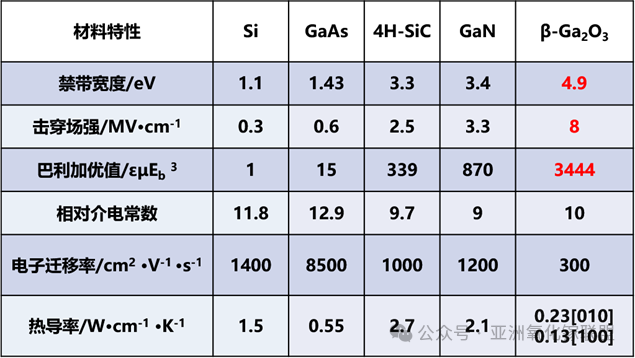
02
氧化镓功率器件类型和特征
Ga2O3功率器件的工作原理主要依赖于其对电场的调控能力与载流子的输运特性,其核心目标是实现高效的电能转换与控制。目前主流研发的功率器件主要包括肖特基势垒二极管(SBD)、金属氧化物半导体场效应晶体管(MOSFET)以及鳍式功率晶体管三种结构。
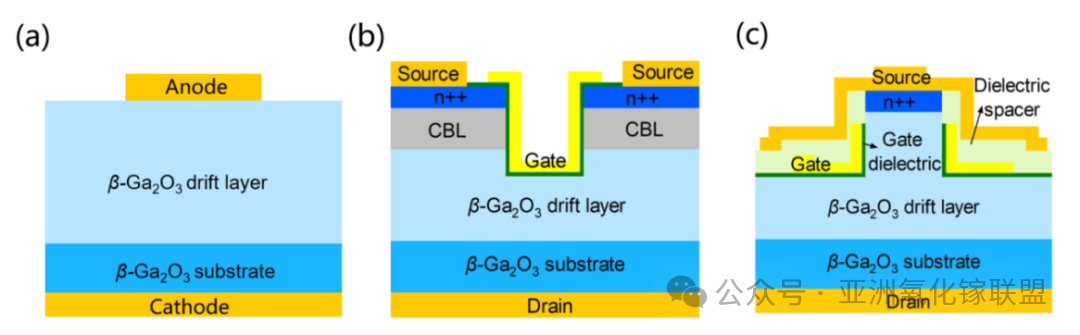
SBD是目前最成熟的氧化镓功率器件。其工作原理基于金属与半导体接触形成的肖特基势垒实现单向导电,如图2(a)所示。该结构无需p型掺杂,工艺相对简单,且具有零反向恢复电荷的特性,开关速度极快。同时,得益于Ga2O3的超高临界击穿电场,器件漂移层可设计得极薄,从而实现理论值极低的比导通电阻,显著降低导通损耗。该器件的核心挑战在于肖特基势垒高度的热稳定性不足,导致高温下反向漏电流增大,影响器件可靠性。需要通过势垒金属工程、终端结构设计等手段进行优化。
MOSFET工作原理通过栅极电压调控沟道导电状态,实现高效电能控制,如图2(b)所示。该结构最大的优势在于通过栅极绝缘层实现了电压控制,驱动简单,且易于实现电路集成。该结构面临两大根本挑战:一是高质量栅氧界面制备困难,氧化镓与介质层界面存在高密度缺陷态,导致阈值电压不稳定、迁移率下降;二是材料本征热导率低引发的严重自热效应,限制其电流处理能力和长期可靠性。开发新型栅介质材料和先进的散热集成技术是突破瓶颈的关键。
鳍式功率晶体管核心特征在于鳍状垂直沟道,图2(c)所示。这种结构带来了两大革命性优势:一是卓越的栅控能力,通过增强的静电控制能有效抑制短沟道效应,为制备高性能增强型(常关型)器件提供了理想路径;二是更高的电流密度,通过增加鳍的数量可在单位面积内提供更大导电通道。然而,该结构的制造面临纳米级鳍片刻蚀工艺的严峻挑战,需要实现侧壁光滑、陡直的高质量鳍结构,且三维结构下的热管理问题更为复杂。
这三种器件结构代表了氧化镓功率器件发展的技术路径——SBD作为率先突破的二极管器件,在高效整流领域展现巨大潜力;MOSFET作为主流开关器件,其界面与散热问题的解决是产业化的关键;而鳍式功率晶体管则代表了面向未来更高集成度和性能的先进技术方向。它们的协同发展将共同推动氧化镓在超高压、高效率电力电子系统中的革命性应用。
03
团队介绍
纳米加工平台在第三代半导体基础上,积极布局与完善了超宽禁带半导体Ga2O3材料与器件的研发能力与技术支撑条件。针对Ga2O3功率器件制备等开展了一系列研究,并搭建了测试系统,形成了专业的研发团队和一定的技术积累。目前在Applied Physics Letters,IEEE Electron Device Letters等国际主流期刊发表SCI论文20余篇,申请国内外发明专利10余项。Ga2O3研发团队现有高级职称5人,博士后1人,在读博士与硕士研究生10余人。
04
平台能力与成果介绍
纳米加工平台已成功开发出高浓度、高均匀性N离子注入掺杂技术,以及低损伤、高各向异性的Ga2O3刻蚀技术。这些核心工艺技术,结合Ga2O3薄膜外延与热处理技术,对Ga2O3功率器件工艺线能力进行了系统性提升,以实现高性能垂直结构功率二极管和晶体管的开发。
在Ga2O3功率器件中,实现高浓度、可控的N型区域选择性掺杂,对于源/漏区浅施主注入、结终端调控(如电荷平衡层、场线环)、栅下改性注入以及绝缘隔离区形成(CBL)等关键掺杂区域构建,是提升器件击穿电压和性能的核心手段。然而,由于氧化镓极高的化学键结合能和热稳定性,传统热扩散掺杂效率极低,因此,离子注入成为氧化镓实现选择性掺杂的唯一可行方案。这一技术面临着两大挑战:一是高温退火激活率低,注入的氮(N)离子在退火后难以有效占据氧(O)位点形成受主;二是晶格损伤严重,高能离子轰击会破坏晶体结构,产生大量缺陷,若不妥善修复,将导致器件漏电激增和可靠性下降。
为攻克这些难题,我们开发了优化的高浓度N离子注入与高温退火工艺。首先,通过多步能量与剂量注入法,在目标区域形成近似盒状的、高均匀性的N型掺杂浓度分布,以满足CBL等结构对掺杂剖面精准控制的要求。注入后的样品需进行高温退火以激活杂质并修复晶格。如图3所示,在氮气或氧气氛围中进行高温退火,是有效激活N杂质、显著降低注入损伤的关键。通过I-V测试证实,经优化工艺处理后,注入区域的电子阻断能力可达到10-6A/cm2量级。
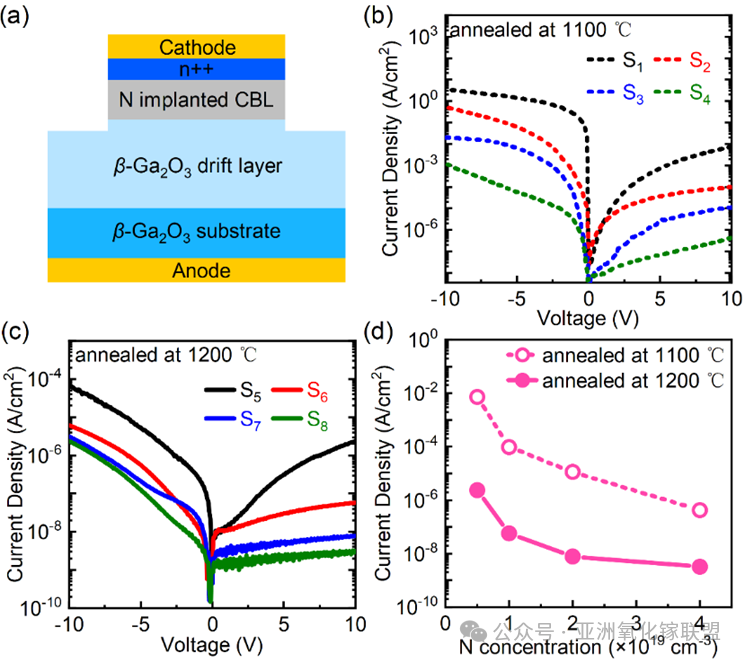
刻蚀技术是定义氧化镓功率器件三维结构(如台面、沟槽、鳍片)的基础。器件的性能,特别是击穿电压和动态特性,与刻蚀侧壁的形貌、损伤和光滑度直接相关。
为此,我们开发了基于感应耦合等离子体(ICP)的低损伤刻蚀工艺。通过精确调控Cl2/BCl3/Ar混合气体的比例、ICP源功率和偏置射频功率等关键参数,在确保高刻蚀速率和高各向异性的同时,最大限度地降低物理轰击损伤。优化的工艺条件能形成以化学反应为主的刻蚀机制,从而获得侧壁陡直、表面光滑的刻蚀形貌。如图4显示,刻蚀出的沟槽和鳍片侧壁角度接近90°,表面粗糙度低。此外,为进一步消除残余损伤和修复侧壁表面,我们在刻蚀后引入了湿法表面处理,以钝化悬挂键,恢复表面化学态。
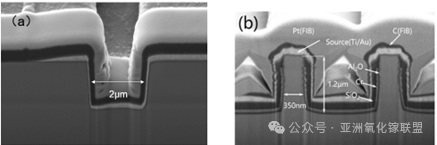
基于多鳍通道结构的欧姆接触阳极二极管(MFCD)代表了氧化镓功率二极管向三维架构演进的重要突破,器件结构如图5所示。该器件的创新性在于利用亚微米尺度鳍状沟道结构引发的自耗尽效应,在器件内部形成了天然的电场调制结构。这种设计在不依赖复杂终端结构的情况下,将高电场下的反向漏电流抑制了约2个数量级。同时,通过优化鳍的深宽比与周期排布,在维持低漏电的同时保证了正向导通时的高电流密度。图6显示,该器件在5 V正向偏压下的电流密度达到400 A/cm2。并通过N离子注入终端使反向击穿电压突破1.6 kV,实现了导通损耗与阻断能力的优异平衡。其制备工艺与传统平面工艺兼容性高,为开发新一代高压、低损耗整流器件提供了可靠路径。图7显示了该器件与其他器件的比较,器件在漏电和导通电阻方面具有很好的潜能。

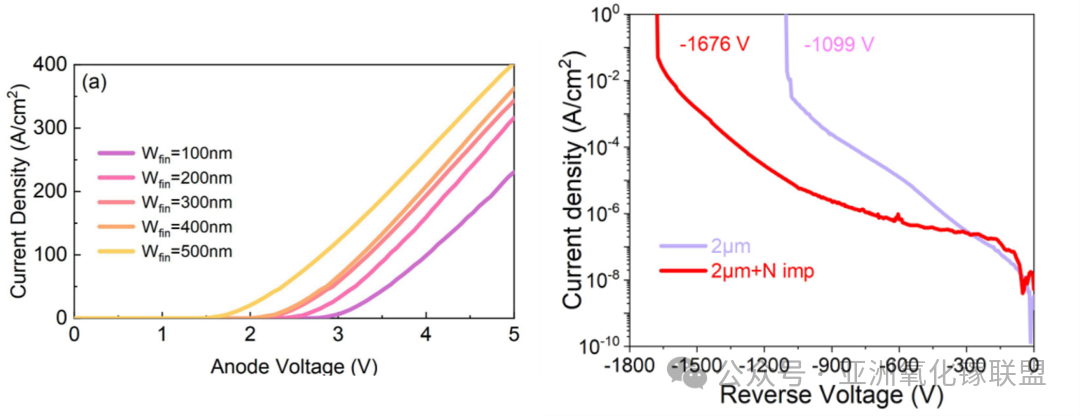
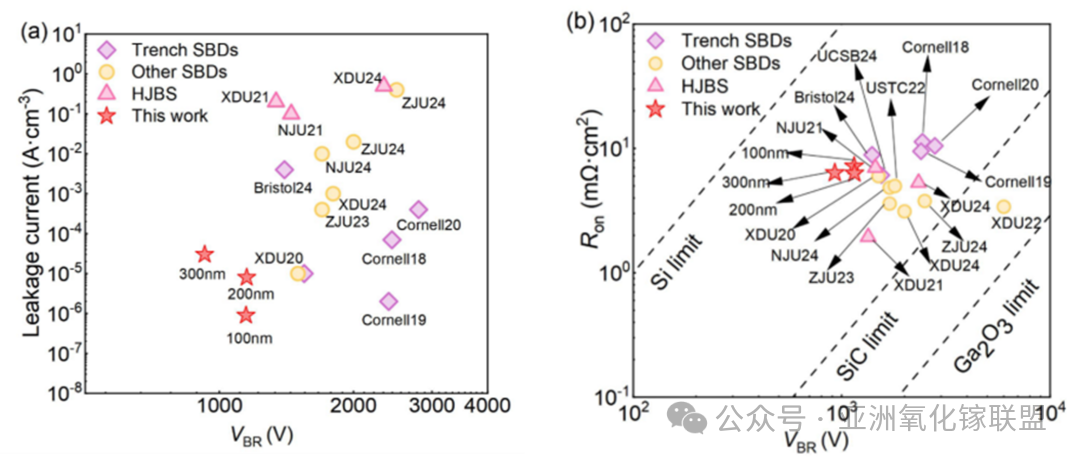
基于N离子注入技术行程的绝缘阻挡层解决了氧化镓功率开关器件的关键瓶颈。器件结构、制备流程、器件的显微镜照片和截面SEM图像如图8所示。在UMOSFET中,N离子注入形成的电流阻挡层(CBL)被精确设计在沟槽区域,通过调节注入浓度(5×1018至4×1019 cm-3)与退火温度(1000-1200 ℃)的协同关系,实现了对垂直电场分布的调控。优化后的CBL使器件击穿电压从348 V提升至1.3 kV。在垂直β-Ga2O3UMOSFET中,采用电流阻挡层(CBLs)的器件通常存在导通电阻增大的问题,这主要是由于沟槽侧壁中的深能级缺陷态捕获了自由电子。在栅极介质沉积前引入HF侧壁处理工艺,对沟槽表面进行改性。该工艺可有效将氟原子掺入侧壁区域,提高电子浓度并缓解重氮注入导致的深受主能级补偿效应,从而改善正向导电性能。此外,HF处理还能部分钝化表面和界面陷阱,并产生温和的抛光效果,略微降低表面粗糙度。这些改进有助于抑制界面散射,进一步提升载流子传输效率。如图9所示,所制备的垂直β-Ga2O3UMOSFET实现了6.0 mΩ·cm2的比导通电阻、19.1 cm2/V·s的沟道迁移率以及1132 V的击穿电压。这些结果表明,HF侧壁处理为显著提升β-Ga2O3UMOSFET的导电性能和整体电学特性提供了一种简单高效的表面工程方法。如图10所示,器件性能与相关报道对比具有很好的导通特性和反向阻断特性。
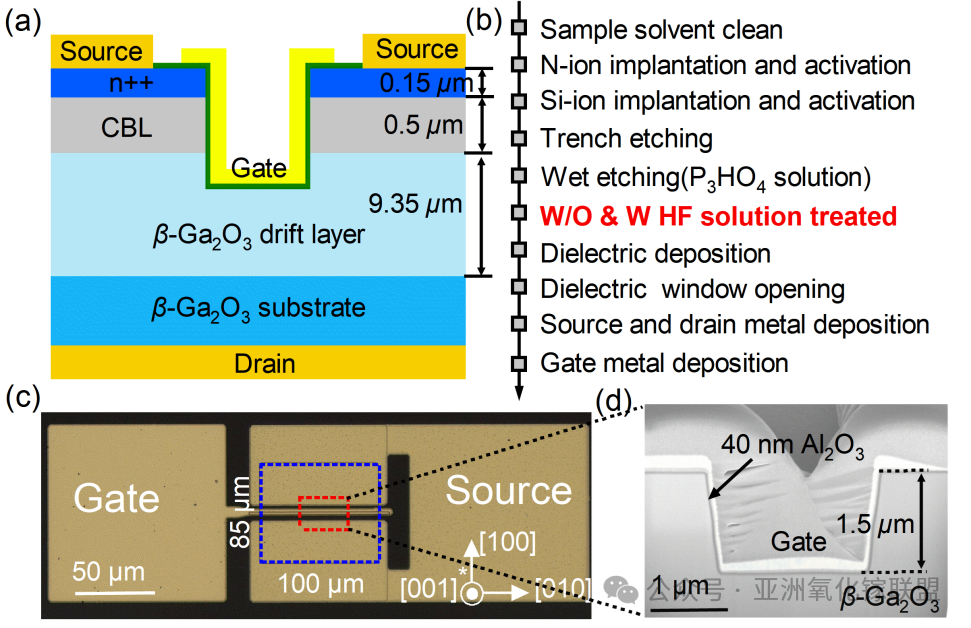
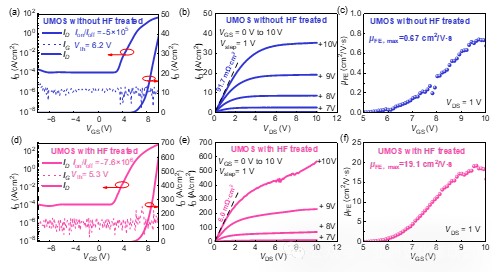
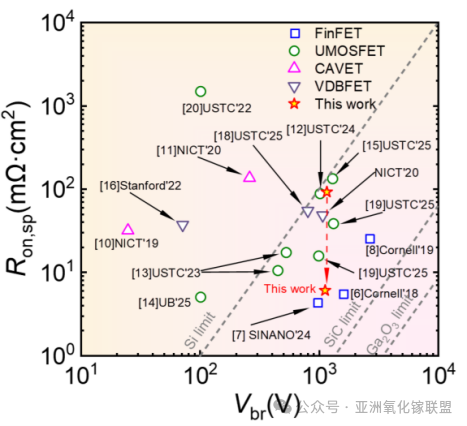
垂直型增强型鳍式功率晶体管通过全三维架构重构实现了氧化镓功率器件的突破。该器件采用光刻胶平坦化的非金属掩模刻蚀和自对准工艺。器件结构设计与截面SEM图像如图11所示。器件性能结果如图12所示,鳍结构宽度与间距的精准控制使得沟道完全耗尽,获得了0.87 V的稳定阈值电压。在电学性能方面,器件通过多鳍并联集成将比导通电阻降至创纪录的4.3 mΩ·cm2,仅为理论极限值的1.8倍。击穿电压达975 V时,其巴利加优值(BFOM)达到0.22 GW/cm2。图13该器件性能与其它工作比较,显示器件具有较好的潜力,这项技术为Ga2O3在万伏级功率系统中的实际应用奠定了坚实基础。
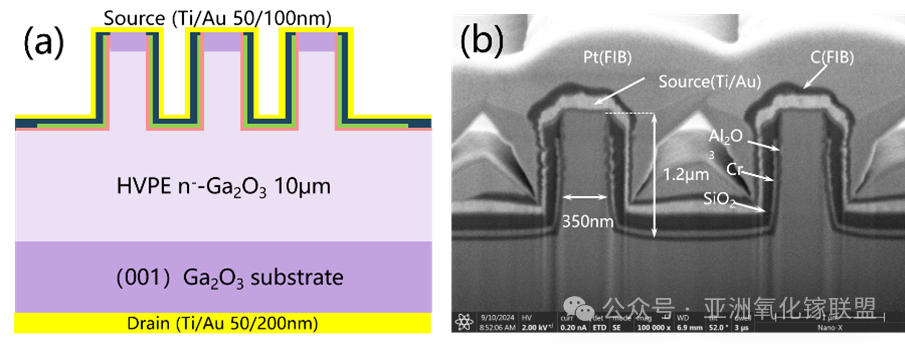

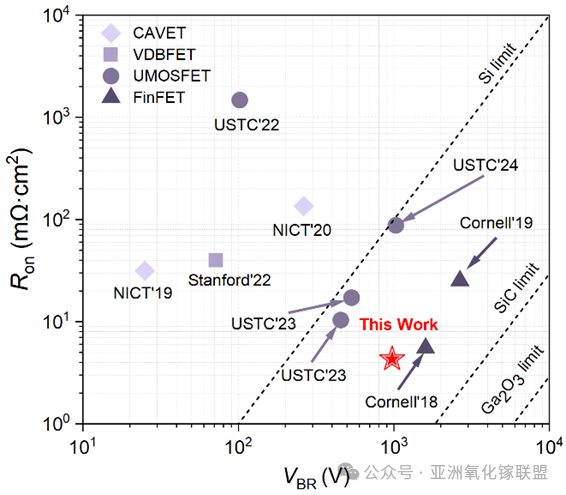
来源:苏州纳米所纳米加工平台
*声明:本文由作者原创。文章内容系作者个人观点,宽禁带半导体技术创新联盟转载仅为了传达一种不同的观点,不代表本联盟对该观点赞同或支持,如果有任何异议,欢迎联系我们。
