
长期以来,半导体面临一个根本矛盾:我们知道下一代材料的性能会更好,却往往不知道如何将它制造出来。“就像我们都知道怎么控制火候,但真正把握好却很难。”周弘这样比喻。近日,郝跃院士张进成教授团队的最新研究在这一核心难题上实现了历史性跨越——他们通过将材料间的“岛状”连接转化为原子级平整的“薄膜”,使芯片的散热效率与综合性能获得了飞跃性提升。这不仅打破了近二十年的技术停滞,更在前沿科技领域展现出巨大潜力,相关成果已发表在国际顶级期刊《自然·通讯》与《科学·进展》。


该论文入选Science Advances封面论文之一
“目前市面上最常见的射频半导体芯片是第三代氮化镓半导体芯片,而该类芯片散热主要由芯片晶体的成核层决定。在我们科研突破之前,这类芯片晶体的成核层都是凹凸不平的,这样崎岖的表面不利于芯片散热,甚至造成散热时的热量‘堵塞’。”西安电子科技大学副校长、教授张进成解释,“热量散不出去,就会囤积在芯片内部,最终导致性能下降甚至器件烧毁。”
此次团队创新性地在第三代半导体芯片晶体上注入高能离子,让晶体成核层崎岖的表面变得平整光滑。 这一突破将半导体的热阻降低至原来的三分之一,解决了第三代乃至未来半导体芯片面临的共性散热难题。

团队的突破,在于从根本上改变了氮化铝层的生长模式。他们创新性地开发出“离子注入诱导成核”技术,将原来随机、不均匀的生长过程,转变为精准、可控的均匀生长。“就像把随机播种变为按规划均匀播种,最终长出了整齐划一的庄稼。”周弘如此形容。这项工艺使氮化铝层从粗糙的“多晶岛状”结构,转变为原子排列高度规整的“单晶薄膜”。
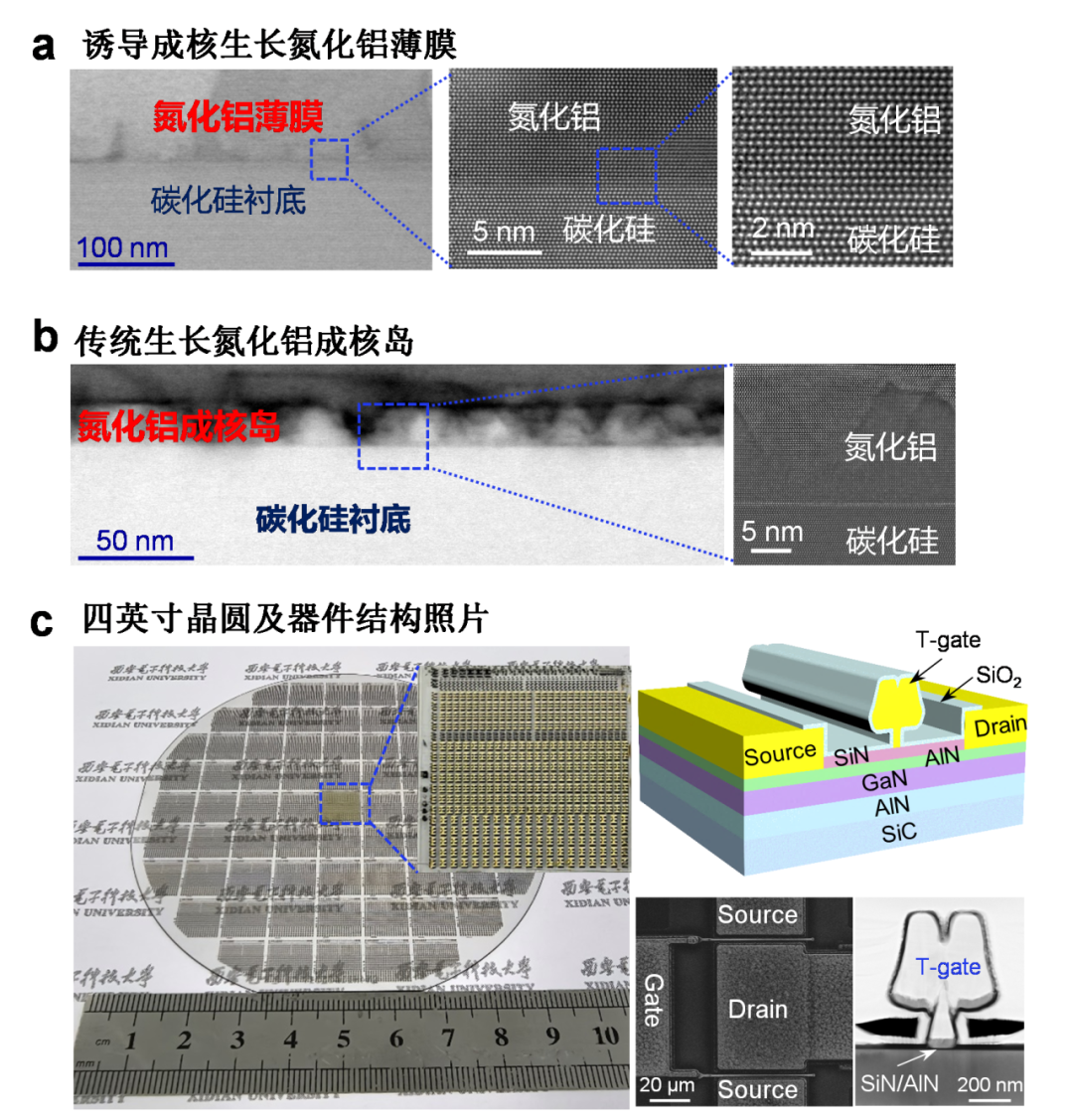
这一技术转变实现了质的跨越:平整的单晶薄膜大幅降低界面缺陷占比,热量可经由缓冲 / 成核层快速传导导出。实验数据验证,新结构的界面热阻仅为传统 “岛状” 结构的三分之一。
这项看似基础的材料工艺突破,精准攻克了从第三代到第四代半导体发展过程中普遍存在的共性散热难题,为器件性能的指数级跃升筑牢了关键根基。
工艺突破直接转化为器件性能的跨越式提升。依托这项创新型氮化铝薄膜技术,研究团队制备的氮化镓微波功率器件,在 X 波段与 Ka 波段分别达成42 W/mm、20 W/mm的输出功率密度。该指标将国际同类器件的性能纪录提升 30%—40%,成为近二十年来该领域最具里程碑意义的技术突破。
“这意味着,在芯片面积恒定的前提下,探测类装备的有效探测距离可实现显著延伸;对于通信基站而言,则能够达成更远的信号覆盖半径与更低的能耗水平。” 周弘表示。
这项技术的红利同样将逐步惠及普通民众。尽管当前民用手机等终端设备暂无需如此高的功率密度,但基础技术的迭代进步具有普惠性。“未来,手机在偏远地区的信号接收能力有望显著增强,续航时长也可能得到进一步提升。”
更深远的价值在于,该技术为 5G/6G 通信、卫星互联网等前沿产业的发展,储备了核心器件层面的关键支撑能力。


推荐阅读
▷绿电耦合 vs 成本陷阱:金刚石企业的 “绿钻” 价值账该怎么算?
▷【Semi-N 2026】感谢相伴!300+精英齐聚宁波,2026高导热封装材料创新论坛圆满落幕!
▷热沉材料:不止于散热
▷工艺升级,3D封装技术挑战
▷2026必有一战?玻璃基板多方竞逐
▷从“芯”降温,金刚石热沉赋能先进封装热管理

来源:西安电子科技大学公众号
声明:Flink未来产链整理,转载请联系:18158256081(同微信)